シリコンフォトニクス活性素子
フォトニクスのアクティブコンポーネントとは、光と物質間の意図的に設計された動的な相互作用を具体的に指します。フォトニクスの典型的なアクティブコンポーネントは光変調器です。現在のシリコンベースのものはすべて光変調器これらはプラズマ自由キャリア効果に基づいています。ドーピング、電気的または光学的方法によってシリコン材料中の自由電子と正孔の数を変化させると、その複素屈折率が変化することがあり、このプロセスは、波長1550ナノメートルにおけるSorefとBennettのデータに適合させることで得られた式(1,2)に示されています。電子と比較して、正孔は実数部と虚数部の屈折率変化のより大きな割合を引き起こします。つまり、与えられた損失変化に対してより大きな位相変化を生み出すことができるため、マッハツェンダー変調器リング変調器では、穴を使用して位相変調器.
さまざまなシリコン(Si)変調器図 10A にタイプを示します。キャリア注入変調器では、光は非常に広い pin 接合内の真性シリコンに配置され、電子と正孔が注入されます。ただし、このような変調器は、注入後の自由電子と正孔の再結合に時間がかかるため、帯域幅が 500 MHz と低速です。そのため、この構造は変調器ではなく可変光減衰器 (VOA) としてよく使用されます。キャリア枯渇変調器では、光部分は狭い pn 接合に配置され、pn 接合の枯渇幅は印加電界によって変化します。この変調器は 50Gb/s を超える速度で動作できますが、バックグラウンド挿入損失が大きくなります。典型的な vpil は 2 V-cm です。金属酸化物半導体 (MOS) (実際には半導体-酸化物-半導体) 変調器は、pn 接合内に薄い酸化膜層を含んでいます。これにより、キャリアの蓄積と枯渇の両方が可能になり、VπLを約0.2 V-cmと小さくすることができますが、光損失が大きく、単位長さあたりの静電容量も大きくなるという欠点があります。さらに、SiGe(シリコンゲルマニウム合金)のバンド端移動に基づくSiGe電気吸収変調器もあります。また、グラフェンを利用して吸収金属と透明絶縁体を切り替えるグラフェン変調器もあります。これらは、高速かつ低損失の光信号変調を実現するためのさまざまなメカニズムの多様な応用例を示しています。
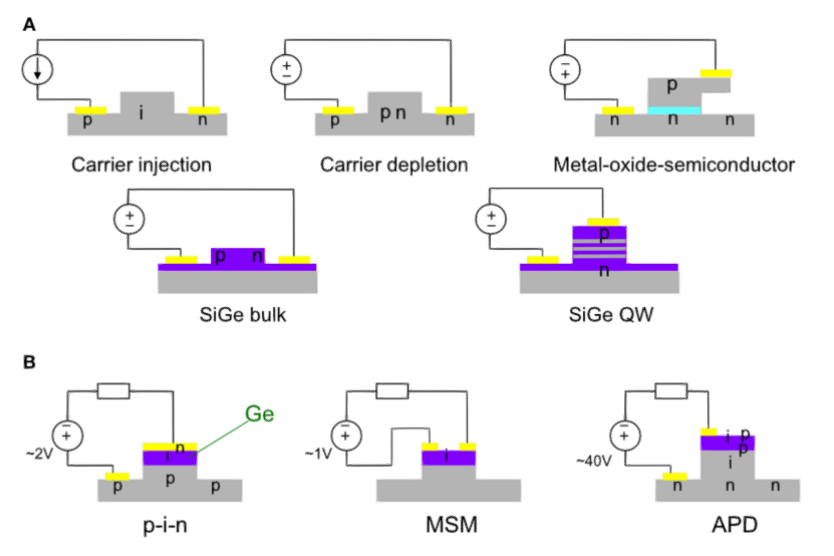
図10:(A)様々なシリコンベースの光変調器設計の断面図、(B)光検出器設計の断面図。
図10Bには、いくつかのシリコンベースの光検出器が示されています。吸収材料はゲルマニウム(Ge)です。Geは、約1.6マイクロメートルまでの波長の光を吸収することができます。左側に示されているのは、現在最も商業的に成功しているピン構造です。これは、Geが成長するP型ドープシリコンで構成されています。GeとSiは4%の格子不整合があり、転位を最小限に抑えるために、まずバッファ層として薄いSiGe層が成長されます。Ge層の上にN型ドーピングが行われます。中央には金属-半導体-金属(MSM)フォトダイオードが示されており、APD(雪崩光検出器右側に図が示されています。APDのアバランシェ領域はSiに位置しており、これはIII-V族元素材料のアバランシェ領域と比較してノイズ特性が低くなっています。
現在、光利得をシリコンフォトニクスに統合する明確な利点を持つソリューションはありません。図 11 は、アセンブリ レベル別に整理されたいくつかの可能なオプションを示しています。一番左は、光利得材料としてエピタキシャル成長ゲルマニウム (Ge) の使用、エルビウム (Er) 添加ガラス導波路 (光ポンピングが必要な Al2O3 など)、およびエピタキシャル成長ガリウムヒ素 (GaAs) 量子ドットを含むモノリシック統合です。次の列は、III-V 族利得領域での酸化物と有機物の接合を含むウェーハ間アセンブリです。次の列は、III-V 族チップをシリコンウェーハのキャビティに埋め込み、導波路構造を機械加工するチップ間アセンブリです。この最初の 3 列のアプローチの利点は、切断前にウェーハ内でデバイスを完全に機能テストできることです。一番右の列は、シリコン チップと III-V 族チップの直接結合、およびレンズとグレーティング カプラを介した結合を含むチップ間アセンブリです。商用アプリケーションへの傾向は、グラフの右側から左側へと移行し、より統合されたソリューションへと向かっている。

図11:光利得がシリコンベースのフォトニクスにどのように組み込まれるか。左から右へ進むにつれて、製造工程における挿入点が徐々に後方に移動する。
投稿日時:2024年7月22日





